英特爾宣布了該行業最早用於下一代高級包裝的玻璃基板之一,該基材計劃在本十年的後期。這一突破性成就將使包裝中的晶體管繼續擴展,並推動摩爾定律以提供以數據為中心的應用程序。
“經過十年的研究,英特爾已經實現了高級包裝的行業領先的玻璃基板。我們期待提供這些尖端的技術,這些技術將使我們的主要參與者和鑄造師在未來幾十年中受益。”
-Babak Sabi,英特爾高級副總裁兼總會和測試開發總經理
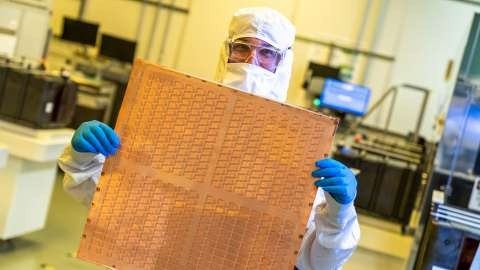
為什麼重要:
與當今的有機基材相比,玻璃具有獨特的特性,例如超低平坦度和更好的熱和機械穩定性,從而在底物中導致互連密度更高。這些好處將使芯片建築師能夠為數據密集型工作負載(例如人工智能(AI))創建高密度,高性能的芯片包。英特爾有望在本十年的下半年向市場提供完整的玻璃基板解決方案,從而使該行業能夠在2030年以後繼續推進摩爾法律。
到本十年末,半導體行業可能會在使用有機材料上在矽包上擴展晶體管的限制,這些材料使用更多的功率並包括收縮和翹曲等限制。縮放對半導體行業的進步和演變至關重要,而玻璃基闆對於下一代半導體是可行且必不可少的下一步。
它的工作原理:
隨著對更強大計算的需求增加,半導體行業進入包裝中使用多個“ chiplets”的異質時代,信號速度,功率傳遞,設計規則和包裝基板的穩定性的提高將是必不可少的。玻璃基板具有優異的機械,物理和光學特性,可以在包裝中連接更多的晶體管,與當今使用的有機基質相比,可以更好地縮放縮放尺度和啟用較大的花栗鼠複合物(稱為“系統中的包裝”)。 Chip Architects將能夠在一個包裝上較小的佔地面積中包裝更多的瓷磚(也稱為chiplets),同時實現性能和密度增長,具有更大的靈活性,較低的總體成本和功率使用情況。
關於用例:
玻璃基板最初將被引入最多可以利用的市場:需要更大的外形套件(即數據中心,AI,圖形)和更高速度功能的應用和工作量。
玻璃基板可以忍受較高的溫度,減少50%的模式失真,並具有超低平坦度,以改善光刻的焦點深度,並具有非常緊密的層到層互連覆蓋所需的尺寸穩定性。由於這些獨特的特性,玻璃基板上可能會增加互連密度10倍。此外,改進的玻璃的機械性能可實現具有非常高的組裝產量的超大形式包裝。
玻璃基闆對較高溫度的耐受性還為CHIP架構師提供瞭如何設定功率傳遞和信號路由的設計規則的靈活性,因為它使他們能夠在更高溫度處理下無縫將光學互連以及嵌入的電感器和電容器和電容器整合到玻璃中。這允許在更低的功率下實現所需的高速信號傳遞,提供更好的動力傳遞解決方案。這些好處使該行業更接近能夠到2030年的包裝上擴展1萬億晶體管。
我們如何做:
英特爾一直在研究和評估玻璃基板作為替代有機基質的可靠性已有十多年了。該公司在啟用下一代包裝方面有著悠久的歷史,在1990年代從陶瓷包裝到有機包裝的過渡中,該行業是第一個實現鹵素和無領先包裝的人,並且是高級嵌入式嵌入式模具包裝技術的發明者,這是該行業的第一個活躍的3D堆疊技術。結果,英特爾能夠將這些技術圍繞這些技術從設備,化學和材料供應商到底物製造商開放整個生態系統。
接下來是什麼:
這些行業領先的玻璃基板在最近的Powervia和RibbonFet突破性的基礎上,用於高級包裝,這表明了英特爾對下一個Comperte時代的前瞻性焦點和視野,超越了Intel 18A流程節點。英特爾(Intel)正在到2030年在包裝上交付1萬億個晶體管的道路,其持續的高級包裝創新(包括玻璃基板)將有助於實現這一目標。