英特尔宣布了该行业最早用于下一代高级包装的玻璃基板之一,该基材计划在本十年的后期。这一突破性成就将使包装中的晶体管继续扩展,并推动摩尔定律以提供以数据为中心的应用程序。
“经过十年的研究,英特尔已经实现了高级包装的行业领先的玻璃基板。我们期待提供这些尖端的技术,这些技术将使我们的主要参与者和铸造师在未来几十年中受益。”
-Babak Sabi,英特尔高级副总裁兼总会和测试开发总经理
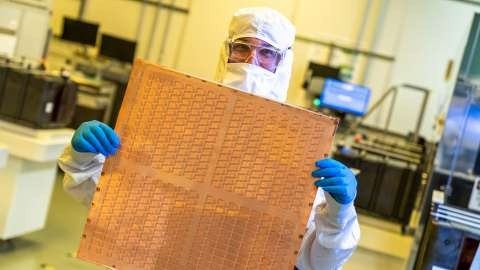
为什么重要:
与当今的有机基材相比,玻璃具有独特的特性,例如超低平坦度和更好的热和机械稳定性,从而在底物中导致互连密度更高。这些好处将使芯片建筑师能够为数据密集型工作负载(例如人工智能(AI))创建高密度,高性能的芯片包。英特尔有望在本十年的下半年向市场提供完整的玻璃基板解决方案,从而使该行业能够在2030年以后继续推进摩尔法律。
到本十年末,半导体行业可能会在使用有机材料上在硅包上扩展晶体管的限制,这些材料使用更多的功率并包括收缩和翘曲等限制。缩放对半导体行业的进步和演变至关重要,而玻璃基板对于下一代半导体是可行且必不可少的下一步。
它的工作原理:
随着对更强大计算的需求增加,半导体行业进入包装中使用多个“ chiplets”的异质时代,信号速度,功率传递,设计规则和包装基板的稳定性的提高将是必不可少的。玻璃基板具有优异的机械,物理和光学特性,可以在包装中连接更多的晶体管,与当今使用的有机基质相比,可以更好地缩放缩放尺度和启用较大的花栗鼠复合物(称为“系统中的包装”)。 Chip Architects将能够在一个包装上较小的占地面积中包装更多的瓷砖(也称为chiplets),同时实现性能和密度增长,具有更大的灵活性,较低的总体成本和功率使用情况。
关于用例:
玻璃基板最初将被引入最多可以利用的市场:需要更大的外形套件(即数据中心,AI,图形)和更高速度功能的应用和工作量。
玻璃基板可以忍受较高的温度,减少50%的模式失真,并具有超低平坦度,以改善光刻的焦点深度,并具有非常紧密的层到层互连覆盖所需的尺寸稳定性。由于这些独特的特性,玻璃基板上可能会增加互连密度10倍。此外,改进的玻璃的机械性能可实现具有非常高的组装产量的超大形式包装。
玻璃基板对较高温度的耐受性还为CHIP架构师提供了如何设定功率传递和信号路由的设计规则的灵活性,因为它使他们能够在更高温度处理下无缝将光学互连以及嵌入的电感器和电容器和电容器整合到玻璃中。这允许在更低的功率下实现所需的高速信号传递,提供更好的动力传递解决方案。这些好处使该行业更接近能够到2030年的包装上扩展1万亿个晶体管。
我们如何做:
英特尔一直在研究和评估玻璃基板作为替代有机基质的可靠性已有十多年了。该公司在启用下一代包装方面有着悠久的历史,在1990年代从陶瓷包装到有机包装的过渡中,该行业是第一个实现卤素和无领先包装的人,并且是高级嵌入式嵌入式模具包装技术的发明者,这是该行业的第一个活跃的3D堆叠技术。结果,英特尔能够将这些技术围绕这些技术从设备,化学和材料供应商到底物制造商开放整个生态系统。
接下来是什么:
这些行业领先的玻璃基板在最近的Powervia和RibbonFet突破性的基础上,用于高级包装,这表明了英特尔对下一个Comperte时代的前瞻性焦点和视野,超越了Intel 18A流程节点。英特尔(Intel)正在到2030年在包装上交付1万亿个晶体管的道路,其持续的高级包装创新(包括玻璃基板)将有助于实现这一目标。









