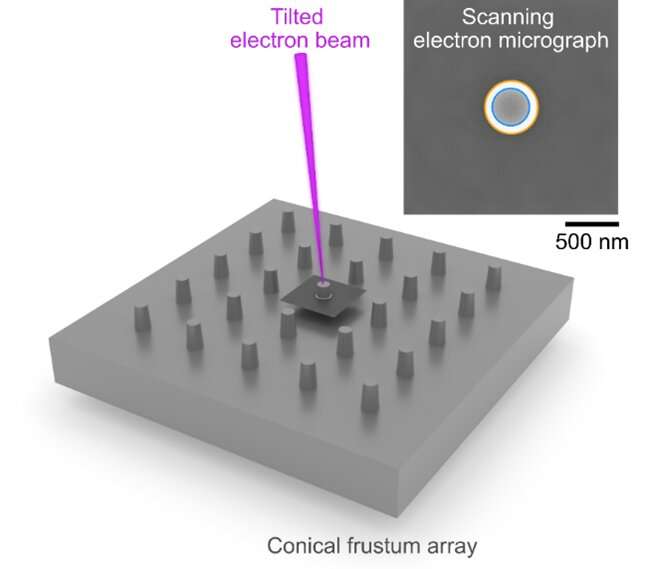
美國國家標準與技術研究院 (NIST) 和半導體及相關產業檢測和測量系統供應商 KLA 公司的研究人員提高了掃描電子顯微鏡 (SEM) 測量的準確性。 SEM 用於半導體製造的製程控制應用,有助於確保功能性高效能晶片的高產量生產。
SEM 使用聚焦電子束對小至一奈米的特徵進行成像,使其成為表徵半導體裝置結構的重要儀器。 在晶片製造過程中,高解析度 SEM 用於許多檢測和計量應用,包括檢測非常小的缺陷、光學檢測員發現的缺陷的識別和分類、圖案特徵的關鍵尺寸測量、重疊測量等。 這些資訊可以幫助晶片工程師描述和微調他們的製造流程。
當電子束穿過 SEM 時,它受到仔細控制。 電子束與理想路徑的輕微偏差或電子束撞擊晶片表面的角度的微小偏差都會導致生成的 SEM 圖像變形並扭曲裝置的結構。 NIST 和 KLA 透過考慮電子束的這些角度偏差提高了 SEM 的精確度。 此聯合研究計畫以小於一毫弧度或百分之五度的精度測量光束傾斜,這需要在角分辨率和測量驗證方面取得進展。
為了測量光束傾斜,NIST 和 KLA 創建了一個原型標準並以新的方式分析了所得的電子顯微照片。 標準原型由一系列逐漸變細的矽柱(稱為圓錐台)組成,它們形成的圖像對光束傾斜高度敏感。 傾斜表現為平截頭體的頂部邊緣和底部邊緣的影像中心之間的偏移。 研究人員利用他們在模擬電子與物質相互作用方面的專業知識,利用模擬來展示亞毫弧度精度的潛力,指導他們正在進行的標準工件的設計和製造。
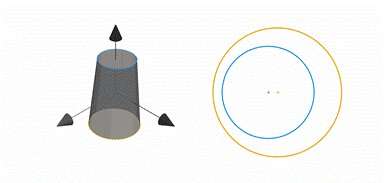
已知位置處的圓錐形截頭體陣列有可能測量 SEM 掃描和成像區域內光束傾斜的任何變化。 這些測量可以進一步校準影像的放大率和失真度。。 此外,新標準也適用於晶片製造中使用的其他顯微鏡方法,包括原子力和超解析度光學顯微鏡。 比較不同顯微鏡方法的結果的能力有助於在不同方法之間可靠且可重複地傳遞訊息,並提高測量模型的準確性。
「電子束傾斜會改變裝置特徵的明顯位置,從而降低 SEM 測量的準確性,」NIST 研究員、涵蓋該研究的行業論文的第一作者 Andrew C. Madison 說道。 “我們的新標準和分析方法可以檢測隨著成像領域的變化而改變。
「利用這些數據,SEM 製造商可以實施校準和校正,從而改善和測量精度,」NIST 研究員兼首席研究員 Samuel M. Stavis 說。
KLA 公司高級副總裁兼總經理熊亞林表示:“作為半導體檢測和計量領域的專家,我們不斷探索能夠擴展電流測量極限的新技術。” “與研究組織的合作在發現有助於推進晶片行業流程控制的創新方面發揮著重要作用。我們與 NIST 的聯合研究旨在提高用於表徵晶片製造流程的基本測量的準確性。”
NIST 計劃透過出版物和最終分發平截頭體陣列,向晶片製造業和科學界廣泛提供新的標準和分析方法。
引文:提升晶片製造的掃描電子顯微鏡測量水準(2023 年5 月31 日),2024 年6 月4 日檢索自https://webbedxp.com/science/jamaal/news/2023-05-scanning-electron-microscope -chip.html
本文件受版權保護。 除私人學習或研究目的的公平交易外,未經書面許可不得複製任何部分。 內容僅供參考。









