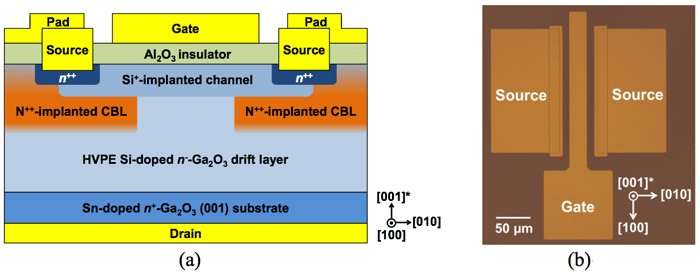
日本國立資訊通信技術研究所 (NICT) 和東京農工大學 (TUAT) 的研究人員展示了垂直 Ga2氧3金屬氧化物半導體場效電晶體(MOSFET),以全離子注入製程進行n型和p型摻雜,為新一代低成本、高可製造性的Ga鋪平了道路2氧3電力電子裝置。
電力電子涉及電機驅動、電動車、資料中心和電網等應用中的電力調節和轉換。 力量,即整流器(二極體)和開關(電晶體),構成電力電子電路的核心元件。 如今,矽 (Si) 製成的功率元件已成為主流,但它們正在接近基本性能限制,導致商用電源系統體積龐大且效率低下。 基於寬禁帶半導體的新一代功率元件(嘎2氧3)預計將徹底改變行業。 嘎2氧3透過提高設備級的功率密度和功率轉換效率,可望大幅減少電源系統的尺寸、重量、成本和能耗。
第一個單晶Ga的突破性演示2氧32011 年 NICT 推出的電晶體激發了國際社會對此新型氧化物半導體的科學和工程的深入研究活動。 近年來,Ga的發展2氧3晶體管專注於橫向幾何形狀。 然而,由於裝置面積大以及自熱和表面不穩定性引起的可靠性問題,橫向裝置無法承受許多應用所需的高電流和高電壓。 相比之下,垂直幾何形狀允許更高的電流驅動,而無需擴大晶片尺寸、簡化的熱管理和遠超優越的現場端接。 垂直電晶體開關的特性是透過在半導體中引入兩種類型的雜質(摻雜劑)來設計的:n 型摻雜,它提供移動電荷載子(電子),以在開關處於導通狀態時攜帶電流; p型摻雜,可在開關處於關斷狀態時達到電壓阻斷。 由 Masataka Higashiwaki 領導的 NICT 團隊率先使用 Si 作為 Ga 中的 n 型摻雜劑2氧3裝置,但業界長期以來一直在努力尋找合適的 p 型摻雜劑。 今年早些時候,同一小組發表了關於氮 (N) 作為 p 型摻雜劑的可行性。 他們的最新成就包括整合 Si 和 N 摻雜來設計 Ga2氧3晶體管首次透過稱為離子注入的高能摻雜劑引入製程實現。
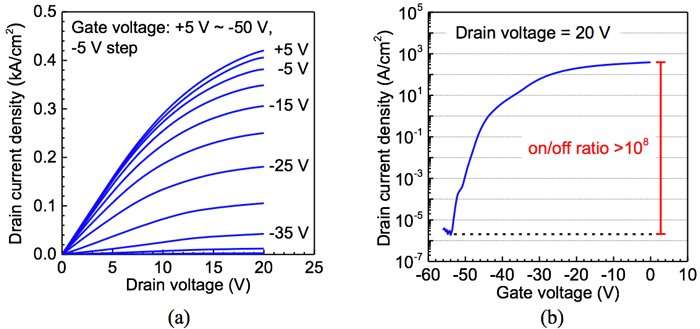
「我們的成功是一項突破性的發展,有望對 Ga 產生變革性影響2氧3NICT 綠色 ICT 裝置高級開發中心主任 Higashiwaki 表示:「功率元件技術。離子注入是一種通用製造技術,廣泛應用於矽和碳化矽 (SiC) MOSFET 等商用半導體裝置的大規模生產中。 全離子注入垂直Ga的演示2氧3電晶體大大增強了Ga的前景2氧3基於電力電子技術。
這項研究於 12 月 3 日發表在IEEE 電子設備通訊作為一篇早期訪問線上論文,計劃發表在該雜誌 2019 年 1 月號上,該論文建立在早期論文的基礎上,其中使用了不同的受體摻雜劑。 「我們最初研究了鎂的 p 型摻雜,但這種摻雜劑未能達到預期的性能,因為它在高製程溫度下會顯著擴散,」綠色 ICT 裝置高級開發中心研究員、紙張。 「另一方面,氮氣的熱穩定性更高,從而為設計和製造各種高壓 Ga 創造了獨特的機會。2氧3裝置."
嘎2氧3用於製造垂直 MOSFET 的基礎材料是透過稱為鹵化物氣相外延 (HVPE) 的晶體生長技術生產的。 由教授開創。 TUAT 的 Yoshinao Kumagai 和 Hisashi Murakami,HVPE 能夠生長單晶 Ga2氧3高速且雜質含量低的薄膜。 三執行步驟以在 MOSFET 中形成 n 型接觸、n 型通道和 p 型電流阻擋層 (CBL)。 此元件表現出良好的電氣性能,包括 0.42 kA/cm2 的導通電流密度2,比導通電阻為 31.5 mΩ·cm2,以及大於八個數量級的高汲極電流開/關比。 透過提高閘極介電品質和優化摻雜方案,可以輕鬆實現其性能的進一步改進。
Higashiwaki 和 Wong 表示:「垂直功率裝置是將超過 100 A 的電流與超過 1 kV 的電壓相結合的最有力的競爭者,這滿足了許多中高功率工業和汽車電氣的要求。系統。2氧3熔體生長原生基板的可用性將大大推動這一趨勢,這是矽產業的關鍵推動因素之一,該產業主導全球半導體市場,年收入達數千億美元。 「垂直SiC和氮化鎵(GaN)的商業化基材的高成本在某種程度上阻礙了這個進程。 對於嘎2氧3與現有的寬頻隙 SiC 和 GaN 技術相比,原生基板的高品質和大尺寸為這種快速新興的技術提供了獨特且顯著的成本優勢,」研究人員解釋道。
由國家資訊通信技術研究所 (NICT) 提供
引文:透過離子注入摻雜開發世界上第一個垂直氧化鎵電晶體(2018 年,12 月13 日),2024 年6 月8 日檢索自https://webbedxp.com/science/jamaal/news/2018- 12-world-vertical-gallium-oxy-電晶體.html
本文件受版權保護。 除私人學習或研究目的的公平交易外,未經書面許可不得複製任何部分。 內容僅供參考。









