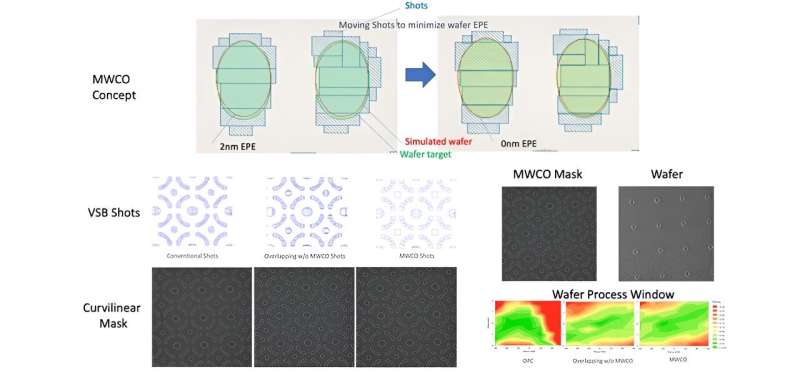
推進半導體晶片技術的核心是一個嚴峻的挑戰:創造更小、更有效率的電子元件。 這項挑戰在光刻領域尤其明顯,光刻是一種在半導體材料(稱為晶圓)上創建複雜圖案以生產晶片的製程。
光刻使用一種稱為光掩模(或簡稱掩模)的模板來在半導體晶圓上創建圖案。 該行業一直在尋找提高掩模和晶圓的分辨率和可製造性的方法,這將生產出更快的晶片,並具有更高的正常運行晶片產量。
提高解析度和圖案保真度的計算光刻技術,例如光學鄰近校正(OPC),透過修改單一掩模圖案以改善掩模和圖案,在應對這些挑戰方面取得了重大進展。印刷。
逆向光刻技術(ILT) 是一種數學上嚴格的逆向方法,可確定將產生所需的晶圓結果的掩模形狀,已被視為解決先進晶片光刻的許多挑戰的有前途的解決方案。 自十多年前推出以來,已有大量研究表明,曲線 ILT 掩模形狀尤其能產生最佳晶圓效果。
然而,直到最近,與這種計算技術相關的運行時間還限制了其在晶片上關鍵「熱點」的實際應用。 2019 年,提出了一種全新的專用系統,其中包括一種獨特的 GPU 加速方法,該方法模擬單個巨型 GPU/CPU 對,可以同時計算整個全晶片 ILT 解決方案。 這種新穎的方法是為 ILT 和 GPU 加速而係統設計的,使全晶片 ILT 在生產中成為現實。
然而,這種方法依賴多光束掩模寫入,這是掩模寫入的一個重要的新發展,它是基於像素的,因此在寫入時間方面與形狀無關。 剩下的問題是,全晶片曲線ILT 的優勢是否可以擴展到可變形狀光束(VSB) 掩模寫入器,這些掩模寫入器寫入直線(有時是三角形)形狀而不是像素,並且構成掩模寫入器的大部分今天世界各地。
雖然 VSB 寫入器透過一次寫入一個矩形鏡頭來快速建立較大的矩形形狀,但複雜的光罩圖案可能是一個問題,因為創建它們所需的大量小矩形會花費很長時間來寫入。
報告他們的工作在裡面微/奈米圖案、材料和計量學雜誌,D2S, Inc. 的團隊發明了一種稱為掩模晶圓協同優化 (MWCO) 的方法,該方法具有三個見解:掩模寫入器和晶圓掃描器都是低通濾波器; 由掩模/晶圓模擬引導的重疊鏡頭可以用更少的鏡頭創建曲線形狀; 透過瞄準晶圓圖案而不是掩模圖案,人們可以創建更簡單的鏡頭來列印正確的晶圓圖案。 透過使用這種雙重模擬,晶圓印刷品質得到迭代優化,同時操縱VSB 發射邊緣以產生已知可在VSB 寫入器上寫入的直線目標掩模形狀,並具有已知且可接受的發射數量。
D2S 和美光科技已經證明,與美光 OPC 相比,MWCO 可以將晶圓偏差降低 3 倍,並且可以將晶圓製程視窗提高 2 倍,這表明光刻製程的精度和可靠性得到了大幅提高。 全曲線ILT掩模的寫入時間將小於12小時,滿足大批量生產要求。
這意味著所有半導體製造商現在都可以生產不僅尺寸更小而且性能更高的晶片,即使他們無法使用多光束掩模寫入器。
更多資訊:Linyong (Leo) Pang 等人,將不可能變為可能:使用可變形狀光束掩模寫入器和曲線全晶片逆光刻技術進行 193i 接觸/通孔,並進行掩模晶圓協同優化,微/奈米圖案、材料和計量學雜誌(2024)。DOI:10.1117/1.JMM.23.1.011207
引文:拋光刻曲線:研究介紹掩模晶圓協同優化方法(2024 年,2 月20 日),2024 年5 月29 日檢索自https://webbedxp.com/science/jamaal/news/2024-02- lithography-mask-wafer-optimization -method.html
本文件受版權保護。 除私人學習或研究目的的公平交易外,未經書面許可不得複製任何部分。 內容僅供參考。









